BGA Underfill – Giải pháp tăng độ tin cậy cho linh kiện đóng gói BGA
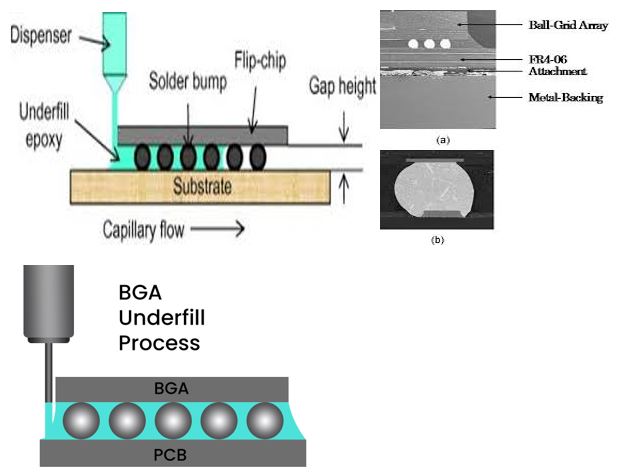
BGA Underfill là gì?
BGA Underfill là vật liệu polymer (thường là epoxy) được bơm vào khoảng trống giữa chip BGA (Ball Grid Array) và substrate/PCB sau quá trình hàn reflow. Khi được đóng rắn (cure), underfill tạo thành một lớp liên kết cơ học giúp bảo vệ các solder ball khỏi ứng suất cơ và nhiệt trong quá trình sử dụng.
Trong các ứng dụng điện tử hiện đại – nơi linh kiện ngày càng mỏng, mật độ I/O cao và điều kiện vận hành khắc nghiệt – underfill gần như là bắt buộc để đảm bảo độ tin cậy dài hạn.
Tại sao BGA cần Underfill?
Sự khác biệt lớn về hệ số giãn nở nhiệt (CTE) giữa:
- Chip silicon
- Solder ball
- Substrate / PCB
sẽ tạo ra ứng suất lớn khi thiết bị trải qua các chu kỳ nhiệt (thermal cycling). Nếu không có underfill, solder ball rất dễ bị:
- Nứt (crack)
- Mỏi hàn (solder fatigue)
- Bong tách (delamination)
👉 Underfill giúp phân tán ứng suất, giảm tập trung lực lên từng solder ball riêng lẻ, từ đó:
- Tăng tuổi thọ mối hàn
- Giảm tỷ lệ lỗi field return
- Nâng cao độ tin cậy sản phẩm
Cấu trúc BGA có Underfill
Sau khi underfill được bơm và đóng rắn:
- Khoảng trống giữa chip và substrate được lấp đầy hoàn toàn
- Solder ball được “khóa” trong khối underfill
- Lực cơ học và nhiệt được phân bố đều hơn trên toàn bộ cấu trúc
Quy trình Underfill trong BGA Packaging

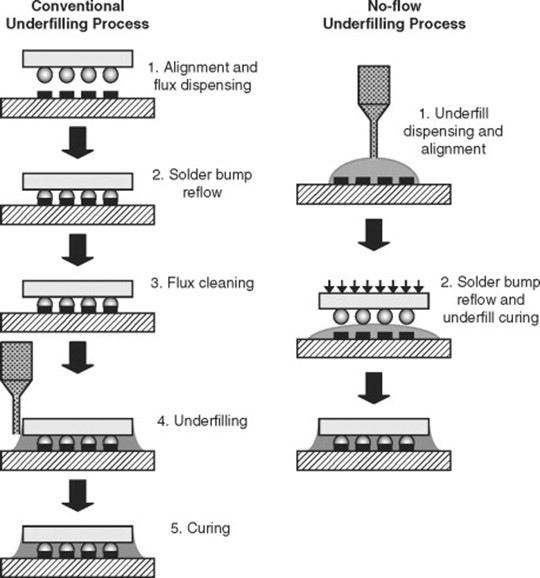
Quy trình tiêu chuẩn gồm các bước:
- Reflow solder – Hàn chip BGA lên substrate/PCB
- Dispensing underfill – Bơm underfill vào cạnh chip, vật liệu tự chảy nhờ lực mao dẫn
- Flow & Wetting – Underfill lan đều, bao phủ toàn bộ solder ball
- Curing – Gia nhiệt để underfill đóng rắn hoàn toàn
⚙️ Các thông số quan trọng cần kiểm soát:
- Độ nhớt (viscosity)
- Tốc độ chảy
- Thời gian & nhiệt độ cure
- Độ bám dính với silicon, solder mask và substrate
Các loại BGA Underfill phổ biến
- Capillary Underfill (CUF)
Phổ biến nhất, bơm sau reflow, độ tin cậy cao - No-flow Underfill
Phủ trước khi reflow, tiết kiệm công đoạn nhưng yêu cầu kiểm soát quy trình chặt chẽ - Corner Bond / Edge Bond
Gia cường tại góc chip, dùng cho ứng dụng yêu cầu cycle time nhanh
Lợi ích chính của BGA Underfill
- Tăng độ bền cơ học cho solder ball
- Cải thiện khả năng chịu sốc nhiệt & rung động
- Giảm lỗi nứt hàn trong thermal cycling
- Nâng cao độ tin cậy cho các ứng dụng ô tô, công nghiệp, thiết bị di động
Ứng dụng của BGA Underfill
- IC đóng gói BGA / FC-BGA
- Thiết bị điện tử tiêu dùng (smartphone, tablet)
- Điện tử ô tô (ADAS, ECU)
- Thiết bị công nghiệp và viễn thông
Kết luận
Trong bối cảnh ngành semiconductor packaging ngày càng đòi hỏi độ tin cậy cao, BGA underfill không chỉ là vật liệu hỗ trợ mà là yếu tố then chốt quyết định tuổi thọ và hiệu suất sản phẩm. Việc lựa chọn đúng loại underfill và kiểm soát tốt quy trình sẽ mang lại lợi thế lớn về chất lượng và chi phí cho nhà sản xuất.
Achilles là nhà phân phối các sản phẩm về wire bond, solder ball và các vật liệu keo kết dính như underfill trong ứng dụng ngành đóng gói bán dẫn. Để tìm được giải pháp cho ứng dụng phù hợp của bạn liên hệ với chúng tôi theo Hotline: 090 194 3684 hoặc email: info@achilles.com.vn để được tư vấn theo đúng nhu cầu của bạn.
————————————————————————————————————————————————————————–
CÔNG TY TNHH ACHILLES (ACHILLES COMPANY LIMITED)
Văn phòng giao dịch: Tầng 5, Toà Machinco 1, Số 10 Trần Phú, Phường Mộ Lao, Quận Hà Đông, TP Hà Nội, Việt Nam
***Hotline: 090 194 3684
***Email: info@achilles.com.vn
***Fanpage: https://www.facebook.com/achillesvn


 English
English